大家好,上一節我們一起和格姆特新材料的小編共同學習了,[底部填充膠](Underfill)中空洞的去除方法的上部分,今天我們將繼續為大家介紹下部分,希望大家點贊收藏。
采用截面鋸斷,或將芯片或封裝從下底部填充膠(underfill)上剝離的方法,這些方法有助于更好地了解空洞的三維形狀和位置,但這種方法最主要的缺點在于它不適用于還未固化的器件。
空洞的起因
空洞產生有一些潛在的根源,通過測試來了解空洞及其產生根源有助于進一步來減少空洞。產生空洞的原因包括:
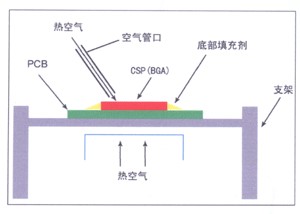
● 流動型空洞——其中還存在著幾種子類型,但所有這些空洞都是在底部填充膠(underfill)流經芯片和封裝下方時產生,流動波陣面的前沿可能會包裹氣泡而形成空洞。
● 水氣空洞——這種類型的空洞是在底部填充膠(underfill)固化時遇上了基板除氣排出的水氣而產生。這種情況通常發生在有機基板中。
● 流體膠中氣泡產生空洞——在材料供應商包裝好的流體膠材料中很少出現氣泡,因為大部分的供應商都很注重封裝材料的無氣泡化。然而,對流體膠材料的處理不當或從供應商
處收到流體膠材料后又對它進行重新分裝就可能會引入氣泡。在有些情況下,供應商提供的
樣品或實驗性流體材料未經充分除氣。而一些自動施膠設備如果沒有設定好的話,也會在施膠時在其流動途徑上產生氣泡。
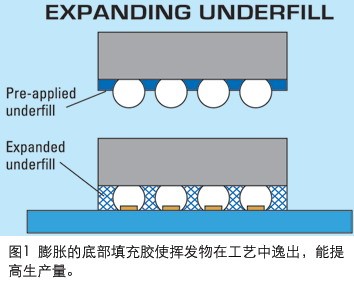
● 沾污空洞——助焊劑殘渣或其他污染源也可能通過多種途徑產生空洞。
空洞的特性
了解空洞的特性有助于將空洞與它們的產生原因相聯系,其中包括:
● 形狀——空洞是圓形的還是其他的形狀?
● 尺寸——通常描述成空洞在芯片平面的覆蓋面積。
● 產生頻率——是每10個器件中出現一個空洞,還是每個器件出現10個空洞?空洞是在特定的時期產生,還是一直產生,或者是任意時間產生?
● 定位——空洞出現在芯片的某個確定位置還是任意位置?空洞出現是否與互連凸點有關?空洞與施膠方式又有什么關系?
以上就是格姆特新材料小編收集底部填充膠(Underfill)中空洞的去除方法的相關知識,格姆特(蘇州)新材料有限公司是專業研發生產各種UV光固化膠、熱固化環氧膠、聚氨酯反應型熱熔膠等電子粘膠劑,產品供應立訊精密、華為、蘋果等國內外知名企業,如有關于電子粘膠劑的朋友可以咨詢溝通,格姆特歡迎您的光臨。本文部分信息/圖片來源于互聯網,僅供行業新資訊分享交流用途,勿作商用。如有涉權,請原著人第一時間告知我們,我們將立即刪除,謝謝。以上就是在高溫環境下關于粘膠劑的一些小知識啦,希望能給大家一些幫助!

